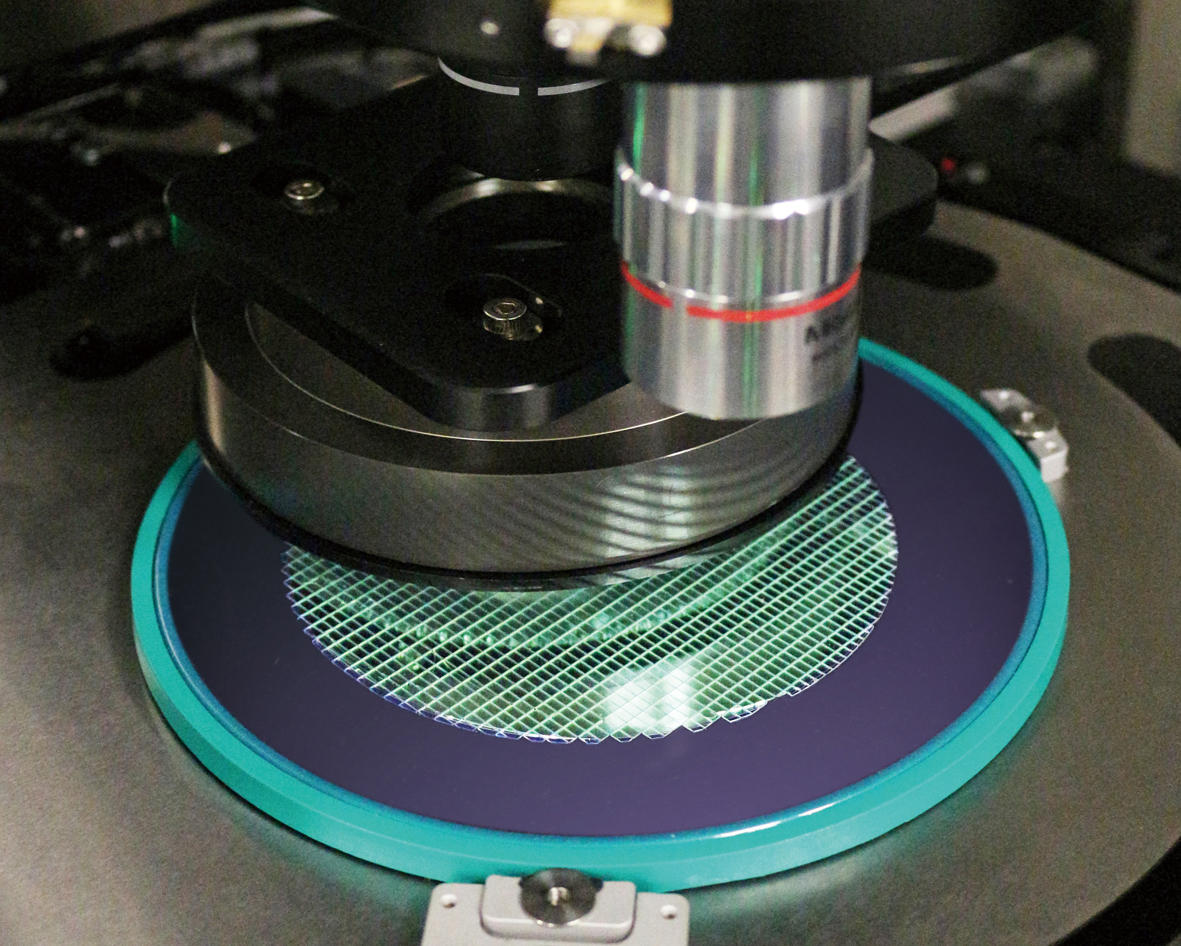
Chroma 7940晶圆检测系统为自动化切割后晶粒检测设备,使用先进的打光技术,可以清楚的辨识晶粒的外观瑕疵。结合不同的光源角度、亮度及取像模式,使得7940可以适用于LED、雷射二极体及光敏二极体等产业。
由于使用高速相机以及自行开发之检测演算法,7940可以在3分钟内检测完6吋LED晶圆,换算为单颗处理时间为15msec。7940同时也提供了自动对焦与翘曲补偿功能,以克服晶圆薄膜的翘曲与载盘的水平问题。7940可配置2种不同倍率,使用者可依晶粒或瑕疵尺寸选择检测倍率。系统搭配的最小解析度为0.5um,一般来说,可以检测1.5um左右的瑕疵尺寸。
系统功能
在扩膜之后,晶粒或晶圆可能会产生不规则的排列,7940也提供了搜寻及排列功能以转正晶圆。此外,7940拥有人性化的使用介面可降低学习曲线,所有的必要资讯,如晶圆分布,瑕疵区域,检测参数及结果,均可清楚地透过使用者介面(UI)呈现。
瑕疵资料分析
所有的检测结果均会被记录下来,而不仅只是良品/不良品的结果。这有助于找出一组最佳参数,达到漏判与误判的平衡点。提供瑕疵原始资料亦有助于分析瑕疵产生之趋势,并回馈给制程人员进行改善。
应用范围
使用在垂直结构LED制程&垂直腔面发射激光器VCSEL制程
| 发光二极体正面检查项目 | ||
|
|
|
| 发光二极体背面检查项目 | ||
|
|
|
| VCSEL正面检查项目 | ||
|
|
|
| VCSEL背面检查项目 | ||
|
|
|









